뜨겁다. 반도체 산업에 슈퍼 사이클(Super Cycle)이 찾아왔다.
슈퍼 사이클이란 특정 산업의 수요가 급증하면서 호황에 접어드는 시기를 뜻한다.
전문가들은 2025년부터 인공지능(AI)이 반도체 산업에 네 번째 슈퍼 사이클을 가져왔다 말한다. AI는 한국에 차세대 반도체라는 새로운 기회를 열었다.
더 높은 성능의 반도체를 만들기 위한 글로벌 경쟁이 심화되는 상황, 연구자들은 기존 반도체의 설계를 바꿔가며, 두뇌를 모사하고 전자와 빛을 이용한 반도체를 연구하며 다음 세대 반도체를 위한 새 밑그림을 그리고 있다.
한국 최고 전문가들이 그리는 반도체의 미래를 미리 만나보고 왔다.

현대 산업의 기초이자 핵심 소재로, ‘산업의 쌀’로 불리는 반도체. 그간 연산을 담당하는 ‘시스템 반도체’와 데이터를 저장하는 ‘메모리 반도체’로 구분돼 사용됐다. 인공지능(AI) 시대에선 그 경계가 허물어진다. AI가 작동하기 위해선 시스템 반도체가 메모리 반도체의 막대한 데이터를 순식간에 불러와야 하기에 둘의 거리가 갈수록 가까워지는 것이다. 현존하는 시스템 반도체와 메모리 반도체를 가장 가깝게 설계한 AI 전용 반도체인 ‘AI 가속기’의 구조를 들여다 보면, 둘의 만남은 물론 차세대 반도체 구조까지 추측할 수 있다.
HBM3E(2026년 3월 기준 가장 최신 모델)
HBM(High Bandwidth Memory, 고대역폭 메모리)은 고성능 DRAM(D램)을 여러 층으로 쌓은 반도체로, 2013년 SK하이닉스가 처음으로 선보였다.
AI 시대가 오며 데이터의 빠른 처리가 요구되자, HBM은 AI를 위한 반도체의 핵심 요소로 자리잡았다. 현재 D램을 12겹으로 쌓는 HBM3E(5세대)까지 출시됐다.
A100칩은 엔비디아의 대표적인 AI 가속기로, 왼쪽 페이지의 단순화된 일러스트 설명과 비교하면 전체 구조를 좀 더 자세히 이해할 수 있다.
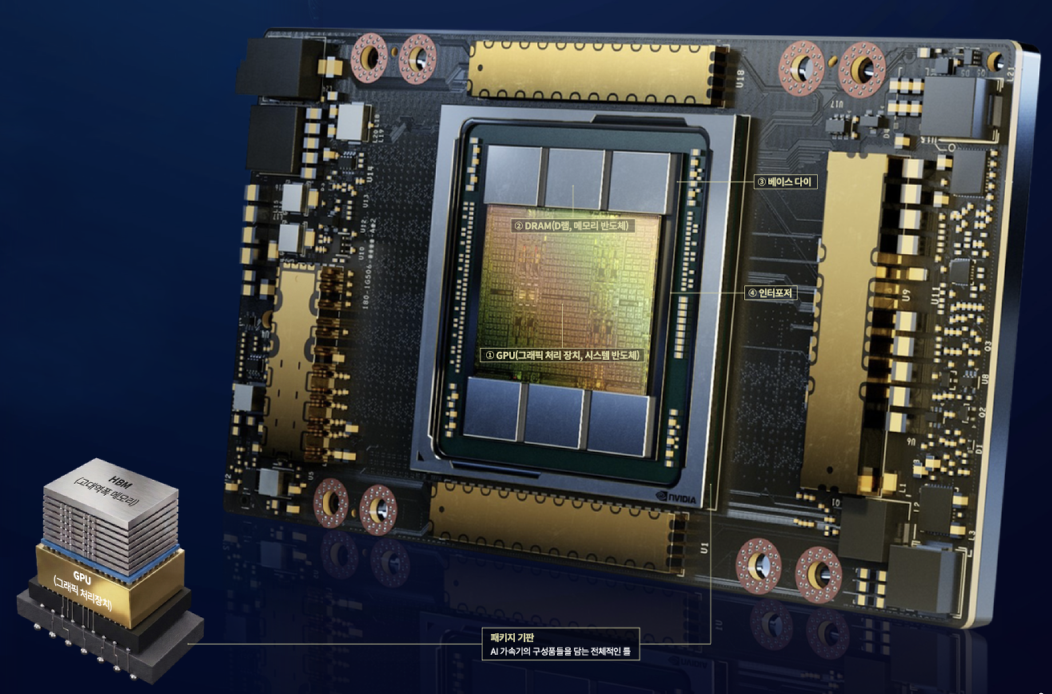
① GPU(그래픽 처리장치, 시스템 반도체)
그래픽, 영상 등 복잡한 시각 작업과 동시에 여러 계산을 하는 병렬 연산을 빠르게 처리하도록 설계된 반도체. AI 학습에서는 방대한 영상 자료를 처리해야 하기 때문에, 기존 PC에서 쓰였던 CPU 대신 병렬 연산을 처리하는 GPU가 주로 사용된다.
② DRAM(D램, 메모리 반도체)
1개의 트랜지스터(외부 회로 사이에서 데이터를 읽고 씀을 제어)와 1개의 커패시터(데이터를 저장)를 1T1C 구조로 합친, 데이터를 일시 저장하는 휘발성 메모리 반도체. HBM은 D램을 여러 겹 쌓은 뒤 반도체 간 통신이 되도록 제작한다.
③ 베이스 다이
D램층 최하단에 위치해 적층된 D램의 데이터 흐름, 전력 관리, 시스템 반도체(GPU, CPU 등)와의 연결 등을 총괄하는 부품.
④ 인터포저
GPU와 HBM을 하나의 패키지 안에서 연결하는 중간 기판. 회로의 선폭과 간격을 촘촘히 만든 미세 배선을 통해 칩 간 초고속 데이터 전송을 지원한다. 칩과 메인 기판 사이의 열팽창을 완충하거나, 칩 간 통신 거리를 최소화해 고대역폭을 확보하는 등 AI 가속기의 안정적 운영 또한 조율한다.
⑤ TSV(실리콘 관통 전극)
수직으로 쌓인 D램 칩들을 전기적으로 연결해 하나의 거대한 메모리 반도체로 작동할 수 있게 만드는 패키징 기술. HBM 내에서 ‘혈관’이나 ‘고속 엘레베이터’와 같은 역할을 하며 대규모의 데이터를 빠르게 전송하는 데 기여한다. 현재 삼성전자와 SK하이닉스, 미국의 마이크론테크놀로지 3곳의 기업만 구현 가능하다.
HBM4(2026년 하반기 출시 예정)
HBM 시장을 양분하는 삼성전자와 SK하이닉스는 6세대 HBM인 HBM4의 2026년 내 출시를 목표로 한다. 3세대인 HBM3E까지 양옆으로 나뉜 채 인접했던 시스템 반도체(GPU)와 메모리 반도체(D램)가 4세대에서는 수직으로 뭉칠 예정이다. 그러면 더 가까워지면서 데이터 전송 속도 및 전력 효율 등이 개선된다.